
【导读】继日矽合并之后,台湾封测厂整并风潮延续。本月硅格宣布将变相控股台星科。在晶圆级封装普及的大背景下,硅格将借助台星科的先进技术打造完整的封测产业链,进一步扩大市占。
近日,台湾封测厂商硅格(矽格股份有限公司:Sigurd Microelectronics)宣布将斥资16.2亿新台币收购新加坡Bloomeria公司全部股份,由此间接获得另一家封测厂商——台星科(Winstek)的控制权。Bloomeria公司隶属新加坡淡马锡集团,除台星科过半股权之外不拥有任何其他资产。若审查进展顺利,这桩交易将在今年四季度前完成,这也是日月光收购矽品之后,台系封测厂商的又一次内部整并。
硅格半导体成立于1996年,总部位于台湾新竹,现资产总值130亿新台币,下辖5座工厂。据官网资料,硅格可完成MEMS、模拟器件、射频器件及存储器的封测。作为被收购方的台星科同样坐落于新竹,于2015年由淡马锡经Bloomeria公司所控股。台星科拥有的Bumping工艺和晶圆级封装技术代表了半导体封装的先进趋势。目前,硅格拥有晶圆级测试技术,收购台星科可获得其封装技术,有利于硅格打造完整的封测产业链,进一步扩大市占率。
随着智能手机、个人电脑以及物联网设备日益严苛的轻薄化取向,其芯片首先必须缩减体积,传统的正贴打线(Wire bond)的封装工艺已不能满足这一需求,诸如移动SoC等高阶芯片必须改善封装技术。通过植球或者光刻电镀的方法,把合金(铅锡、金锡等)的凸点做到芯片表面,然后倒装在基板上的Bumping工艺成为新的趋势,它可以缩减芯片所占的空间,也更有利于散热。在众多的封装类型中,BGA封装是Bumping工艺的一种典型应用。
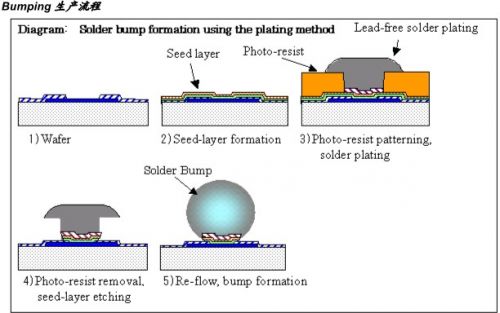
Bumping工艺流程图,在芯片曝光蚀刻完成后植入凸点,然后再倒置于基板上
除了Bumping工艺之外,硅格入主台星科的另一项看重的点就是晶圆级封装。具体来看,晶圆级封装(Wafer Level Packaging, WLP)一次性完成所有芯片制造的后道工序——包括装片、电连接、封装、测试——然后再划片,划完的芯片已经是封装好的成品。之后,将芯片倒装焊到PCB基板上完成整套工序。相比需要先分割晶圆再测试的传统封装方式,晶圆级封装的效率要远远高于前者,同时,采用晶圆级封装的芯片还兼具倒装芯片的优势,即轻薄、散热表现好。
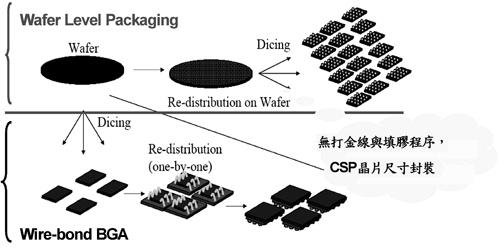
晶圆级封装直接在芯片蚀刻完成后的整晶圆上进行测试与封装,然后再划片
晶圆级封装的市场需求来源于消费市场对设备轻薄、高性能的需求,主要应用在移动SoC、模拟器件、射频器件及图像传感器之上等芯片上。近年来,移动设备轻薄化的取向更为明显,引得芯片封测行业竞争加剧,促进了高阶技术的发展。以晶圆代工闻名的大厂——台积电为苹果A10芯片推出了新的扇出型晶圆级封装(FoWLP),这一技术用植入胶层的方法以增加I/O接点数目,适用于结构更为复杂的芯片。除此以外FoWLP也取消了传统晶圆封装所采用的PCB基板,所以芯片可以做到更轻量化,封装成本也更低。
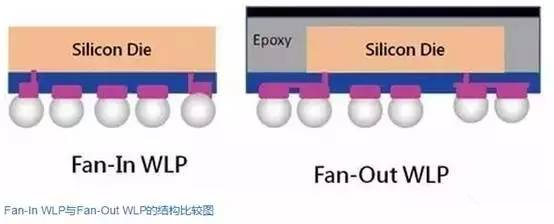
相比传统晶圆级封装,FoWLP加入了封装胶层,以增加I/O接点数目
自台积电首在苹果芯片上首次应用FoWLP之后,专业的封测厂对该领域的重视达到空前高度。上半年,安靠(Amkor)收购欧洲最大的封测厂NANIUM S.A.,意在获取后者先进的扇出型封装技术,以迅速扩充市场份额。数据显示,NANIUM已利用最先进的300mm晶圆封装产线出货近10亿颗扇出封装产品。除此以外,台系厂商日月光也正开发扇出型封装技术,并谋求与矽品合并,以抗衡台积电。
随着物联网、VR、AI等产业的崛起,高效能、轻量化的芯片封装技术成为市场刚需。与芯片厂商相同,封测厂之间的整并风潮也已启动多时,这轮产业整合无疑将使优势技术集中于少数大厂之手,届时封测厂商也会承袭芯片厂的格局,若干巨头企业,将瓜分绝大部分后端封测市场的份额。
ICNET原创,转载请注明。